
ROIC pattern proximity exposure simulation
Sunday, Dec 10, 2017
In order to study and optimize the mask aligner process conditions for proximity exposure process on the Asteroid ROIC wafer, EVG performed exposure simulations with the ROIC pattern design.
The specific mask aligner exposure simulation software used by EVGs process department allows the variation of exposure light source parameters - like collimation angle or spectral distribution - as well as defining different proximity exposure gaps in order to simulate the resulting pattern shape in user defined photo resist.
Utilizing this capability helped reducing labor work in cleanroom and gaining a better understanding of the process limitations with proximity exposure of the quasi-periodic structures for the Asteroid ROIC wafer.
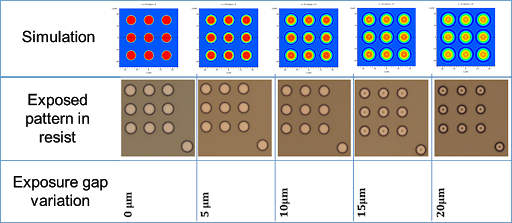
Simulated and exposed resist structures. Identical mask layout resulting in different pattern shape caused by proximity effects influenced by light source shape and exposure gap variation.






